一. 試驗目的:觀察BGA焊接效(xiào)果、鍍層厚度分析
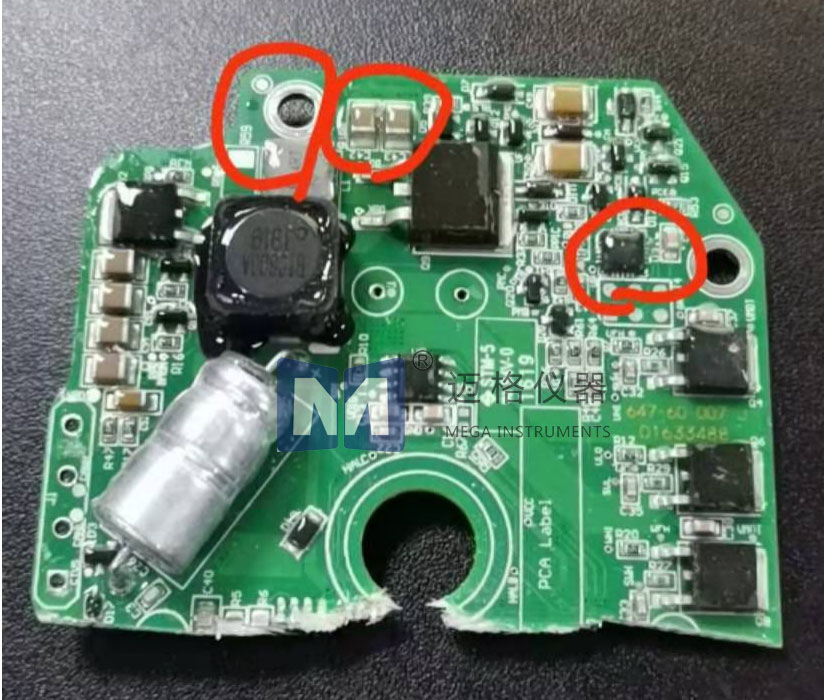
樣件檢測位置
一. 試驗過程:
1. 試樣切割(gē)
2. 試樣(yàng)鑲(xiāng)嵌
3. 試樣磨拋
4. 顯微鏡觀察
二. 使用設備(bèi):
1. AutoCUT 200B自動切割機
2. CAST 1000P壓力鑲嵌機(jī)
3. 手動(dòng)磨拋機UniPOL 202D
4. VMM5000R顯微鏡
三. 試驗步驟如下:
4.1 試(shì)樣切割------ AutoCUT 200B自動切割機

將PCB上的BGA使用切割機從中間切割取樣(yàng)



二、試樣鑲嵌------ 環氧樹脂配壓力(lì)鑲嵌機
將取好的試樣放於特定的模具,使用環氧樹脂進行澆注鑲嵌固定試樣,並起到保護(hù)作用,使(shǐ)試樣在後麵的製作過程中不受損傷,並放於壓力(lì)室(shì)內將試樣內部的(de)氣體(tǐ)排出。

三、試樣磨拋------ UniPOL 202D磨拋機

將鑲嵌(qiàn)好的試樣放於磨(mó)拋機(jī)上使用不同粒度的砂紙,經過不同(tóng)粒度發砂紙多次打磨,使用拋光布和金(jīn)剛石拋光劑拋光後得到(dào)光潔(jié)的表(biǎo)麵,打磨過程中(zhōng)需要有水進行冷卻,清洗.
粗磨:120#
細磨:600#,1200#
精磨:2500#-4000#
拋(pāo)光:紅絨拋光布配2.5um金剛石拋光劑

四、試樣拍照
IC芯片用VMM5000R金相(xiàng)顯微鏡
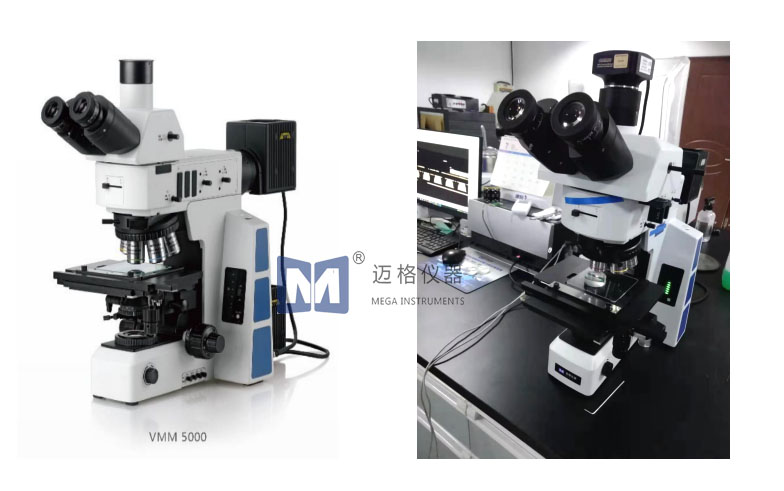
觀察結果(guǒ)如下:
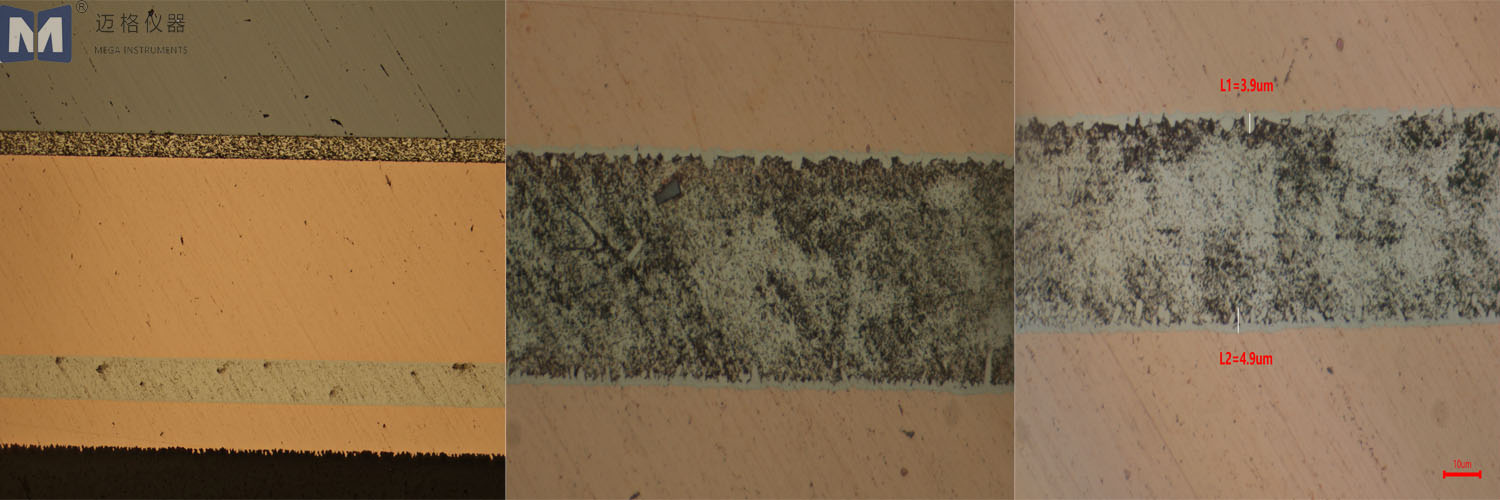
圓孔(kǒng)(鍍層厚度(dù))
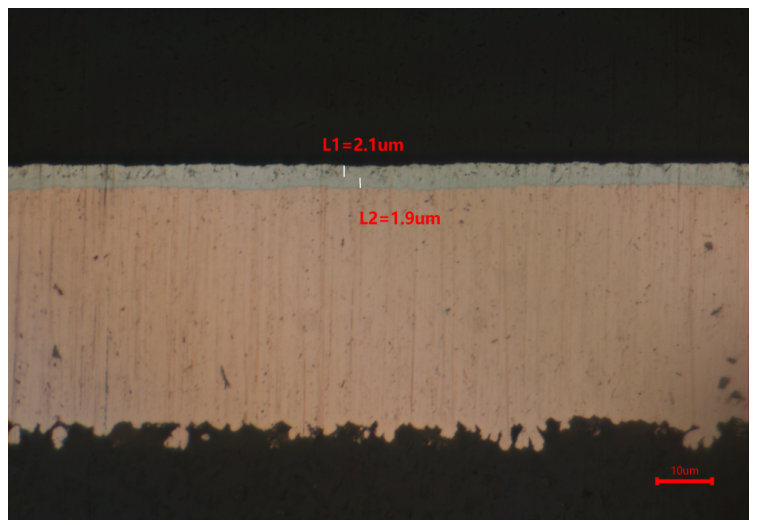
電(diàn)容失效觀察-體視顯微(wēi)鏡MST3000

觀察結果如下: